半導體先進製程競英特爾動態一直是全球注目焦點。英特爾近期於美國檀香山舉行的年度VLSI國際研討會,公布Intel 4製程的技術細節。英特爾表示,在此製程導入極紫外光(EUV)微影設備,讓晶片效能比Intel 7,功耗提升逾20%,高效能元件庫密度則提升2倍,將應用於生產PC客戶端的Meteor Lake處理器,2025年量產。
英特爾表示, Intel 4於鰭片間距、接點間距以及低層金屬間距等關鍵尺寸,持續朝向微縮的方向前行,並同時導入設計技術偕同最佳化,縮小單一元件的尺寸。透過FinFET材料與結構上的改良提升效能,Intel 4單一N型半導體或是P型半導體,其鰭片數量從Intel 7高效能元件庫的4片降低至3片。綜合上述技術,使得Intel 4能夠大幅增加邏輯元件密度,並縮減路徑延遲和降低功耗。
英特爾強調,該公司在Intel 7已導入自對準四重成像技術(SAQP)和主動元件閘極上接點(COAG)技術來提升邏輯密度。前者透過單次微影和兩次沉積、蝕刻步驟,將晶圓上的微影圖案縮小4倍,且沒有多次微影層疊對準的問題;後者則是將閘極接點直接設在閘極上方,而非傳統設在閘極的一側,進而提升元件密度。
至於Intel 4,更進一步加入網格布線方案,簡單化並規律化電路布線,提升效能同時並改善生產良率。
英特爾指出,隨著製程微縮,電晶體上方的金屬導線、接點也隨之縮小;導線的電阻和線路直徑呈現反比,該如何維持導線效能抑是需要克服的壁壘。
Intel 4採用新的金屬配方稱之為強化銅(Enhanced Cu),使用銅做為導線、接點的主體,取代Intel 7所使用的鈷,外層再使用鈷、鉭包覆。
英特爾強調此配方兼具銅的低電阻特性,並降低自由電子移動時撞擊原子使其移位,進而讓電路失效的電遷移(electromigration)現象,為Intel 3和未來的製程打下基礎。
此外,為了減少光罩數及製程步驟,英特爾不僅在現有良好解決方案中的最關鍵層使用EUV,而且在Intel 4的較高互連層中使用EUV。其降低製程的複雜性,也同步替未來製程節點建立技術領先地位及設備產能。英特爾表示將在Intel 4更廣泛地使用EUV,更將導入全球第一款量產型高數值孔徑(High-NA)EUV系統,展現英特爾要在半導體製程重返領先地位的決心。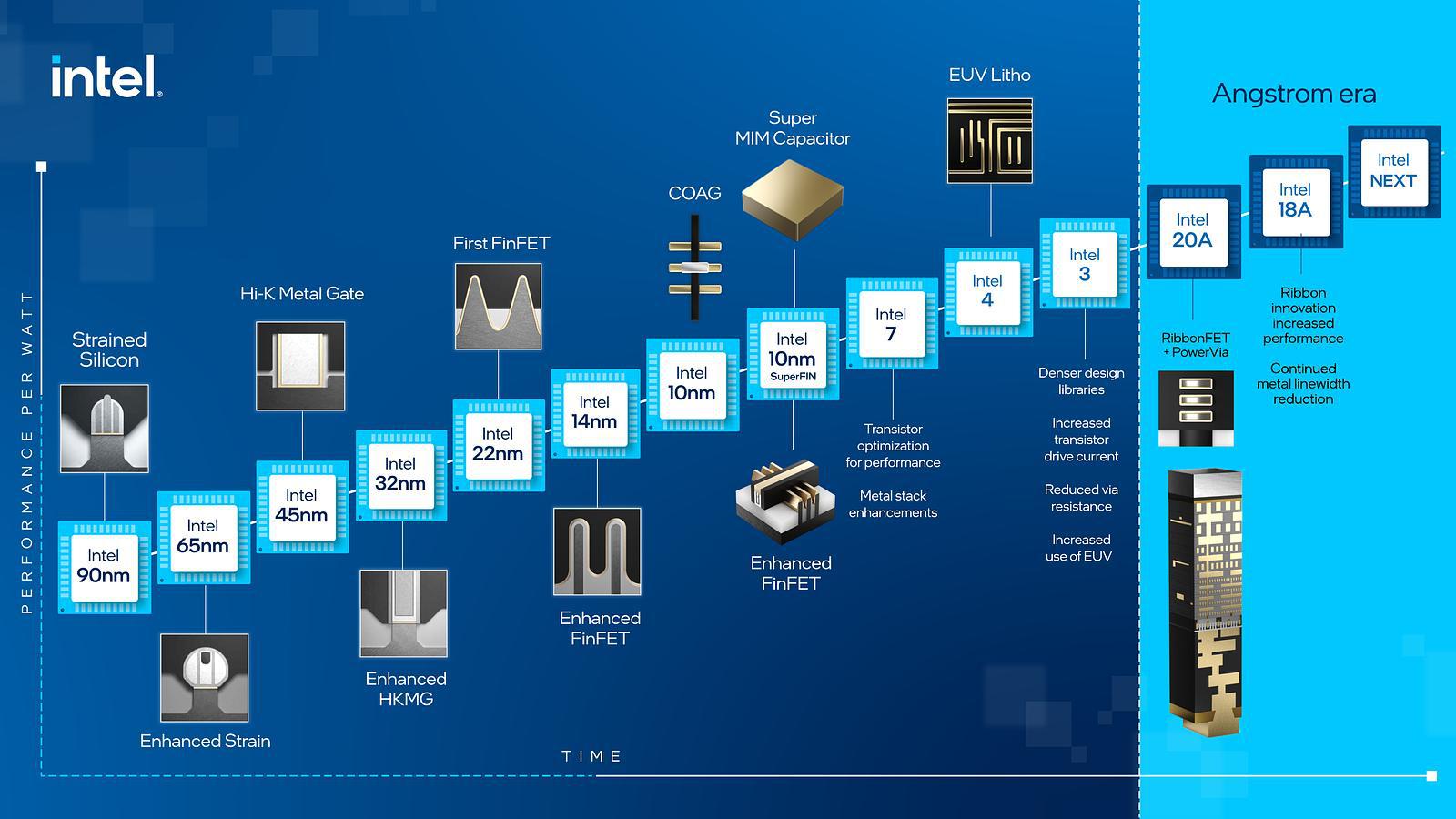
鄭重聲明:本文版權歸原作者所有,轉載文章僅為傳播信息之目的,不構成任何投資建議,如有侵權行為,請第一時間聯絡我們修改或刪除,多謝。
標題:英特爾將於Intel 4導入EUV 預定2025年產出
地址:https://www.torrentbusiness.com/article/4994.html
標籤:
你可能感興趣

美降息效力持續中國振興措施可期 亞股漲多跌少
2024/09/23 19:20
亞洲實力指數超越日本 印度成綜合實力第三大強國
2024/09/23 16:39
AI新創公司背後大金主…中東主權基金扮要角 軟銀效應成隱憂
2024/09/23 14:39
自助點餐機問世25年工作消失?勞力重分配 訂單也增加
2024/09/23 14:15
讓北卡百年老報復活 前主管有套收購計畫
2024/09/23 14:14
